主要功能:
可用于微纳结构中抗腐蚀层和电子器件中的SiO2,SiNx和Poly等绝缘层高温条件下的薄膜生长。
技术指标:
片内厚度均匀性:3%
每一批次内的片间厚度重复性:3%
不同批次之间的厚度重复性:3%
晶片尺寸:4寸
可实现的工艺温度范围:400℃-1100℃,
三个温度区间的温度的准确性和稳定性:±0.5℃
工艺气体:SiH4,NH3,SiH2Cl2,PN2,H2,O2
沉积材料:SiO2(干氧和湿氧),SiNx,Poly(多晶硅 )
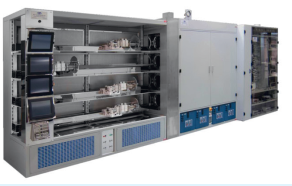
主要功能:
可用于微纳结构中抗腐蚀层和电子器件中的SiO2,SiNx和Poly等绝缘层高温条件下的薄膜生长。
技术指标:
片内厚度均匀性:3%
每一批次内的片间厚度重复性:3%
不同批次之间的厚度重复性:3%
晶片尺寸:4寸
可实现的工艺温度范围:400℃-1100℃,
三个温度区间的温度的准确性和稳定性:±0.5℃
工艺气体:SiH4,NH3,SiH2Cl2,PN2,H2,O2
沉积材料:SiO2(干氧和湿氧),SiNx,Poly(多晶硅 )